pakowanie cowos
TSMC planuje podnieść ceny na swoje usługi. Najbardziej podrożeją zaawansowane metody pakowania chipów

Postęp technologiczny bardzo często wiąże się z koniecznością ponoszenia coraz wyższych kosztów. Składają się na nie niezbędne ulepszenia w zakresie procesów technologicznych, ale także wydatki badawczo-rozwojowe. W tym kontekście nie jest zaskoczeniem, że TSMC planuje podnieść ceny na swoje usługi. Podwyżki najmocniej odczują podmioty, które korzystają z najbardziej zaawansowanych metod pakowania chipów tajwańskiej firmy.
Cały potencjał TSMC w zakresie pakowania CoWoS i SoIC został zarezerwowany do końca 2025 roku

Pakowanie CoWoS jest nieodłącznym elementem produkcji chipów, które wykorzystywane są do obsługi i treningu sztucznej inteligencji. Jest to też obecnie jedno z głównych ograniczeń stojących na drodze do znaczącego zwiększenia podaży akceleratorów AI. Choć pakowanie CoWoS nie jest wyłączną domeną TSMC, to najwięksi producenci układów graficznych sięgają zwykle po rozwiązanie tajwańskiej firmy. Rezerwacje obejmują aktualnie niemal dwa lata w przyszłość.
TSMC planuje budowę kilku nowych placówek produkcyjnych na Tajwanie. Związane z nimi inwestycje mają osiągnąć pokaźną kwotę

TSMC jest jedną z najdynamiczniej rozwijających się firm w branży półprzewodników. Producent chipów nie oszczędza na inwestycjach, dzięki czemu otrzymujemy coraz wydajniejsze chipy, opracowane w mniejszych procesach technologicznych. Spółka planuje budowę kolejnych placówek produkcyjnych na swoim rodzimym Tajwanie. Zajmą się one przede wszystkim pakowaniem CoWoS, które jest kluczowe dla chipów wykorzystywanych w sektorze AI.
NVIDIA będzie współpracowała z Intelem przy pakowaniu chipów wykorzystywanych do obsługi sztucznej inteligencji
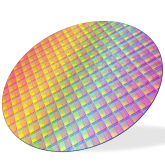
Nic nie wskazuje na to, żeby boom na sprzęt służący do obsługi sztucznej inteligencji miał się w najbliższym czasie zakończyć. Wiemy, że chętni na zakup akceleratorów NVIDII muszą ustawiać się w kolejki i czekać kilka lub nawet kilkanaście miesięcy na realizację zamówień. Nic zatem dziwnego w tym, że amerykańska firma stara się zwiększyć podaż swoich urządzeń. Źródła donoszą, że nawiązana została w tym celu współpraca z Intel Foundry Services.
TSMC mocno rozbudowuje swój potencjał w zakresie pakowania CoWoS. To efekt popularności sprzętu napędzającego AI

TSMC oferuje swoje usługi wielu firmom z branży technologicznej. Niestety oznacza to także, że tajwańskie przedsiębiorstwo jest "wąskim gardłem" w produkcji niektórych rozwiązań. Tak jest chociażby w przypadku pakowania CoWoS, które pozwala na uzyskanie dużego zagęszczenia i wydajności połączeń pomiędzy układami scalonymi. Zapotrzebowanie jest na tyle duże, że TSMC postanowiło radykalnie rozbudować swój potencjał w tym zakresie.




























NVIDIA GeForce RTX 5000 - statystyki cenowe kart graficznych Blackwell na kwiecień 2026. Jak wyglądają kwoty na tle MSRP?
Test procesorów AMD Ryzen 7 7800X3D vs Ryzen 7 9800X3D vs Ryzen 9850X3D - Czy warto dopłacać do szybszych modeli?
Test wydajności Pragmata z Path Tracing - Klęka nawet GeForce RTX 5090! Lepiej przygotujcie upscaling i generator klatek
Tak będą wyglądać testy kart graficznych od Tyrion83. Tylko uczciwe, obiektywne i realne scenariusze
ASUS ROG Equalizer to nowy przewód 12V-2x6. Producent obiecuje niższe temperatury i równy rozkład prądu