Intel przedstawia projekt szklanych substratów dla pakowania chipów EMIB na targach NEPCON 2026 w Japonii
 Od dłuższego czasu wiadomo, że sektor technologiczny coraz wyraźniej zwraca się ku wykorzystaniu szklanych substratów, które w przyszłości mają zastąpić obecnie stosowane substraty organiczne („płytki” znajdujące się pod rdzeniami CPU i GPU). Choć w ubiegłym roku świat obiegły plotki, jakoby Intel odkładał w czasie rozwój technologii Glass Core Substrate, firma stanowczo im zaprzeczyła, a pierwsze efekty tych prac zaprezentowano właśnie teraz na targach NEPCON 2026 w Japonii.
Od dłuższego czasu wiadomo, że sektor technologiczny coraz wyraźniej zwraca się ku wykorzystaniu szklanych substratów, które w przyszłości mają zastąpić obecnie stosowane substraty organiczne („płytki” znajdujące się pod rdzeniami CPU i GPU). Choć w ubiegłym roku świat obiegły plotki, jakoby Intel odkładał w czasie rozwój technologii Glass Core Substrate, firma stanowczo im zaprzeczyła, a pierwsze efekty tych prac zaprezentowano właśnie teraz na targach NEPCON 2026 w Japonii.
Intel na targach NEPCON 2026 w Japonii zaprezentował projekt szklanych substratów w pakowaniu chipów typu EMIB, przeznaczonych dla układów serwerowych oraz zastosowań związanych ze sztuczną inteligencją.
Procesory Intel Alder Lake osiągnęły status EOL. Producent wycofuje z oferty swoje pierwsze hybrydowe układy
Intel to jedna z pierwszych firm na świecie, która rozpoczeła pracę nad wytworzeniem i wprowadzeniem szklanych substratów do produkcji procesorów, wyprzedzając przy tym nawet TSMC. Technologia ta pozwala na większą głębię ostrości przy wytrawianiu ścieżek, większą gęstość połączeń oraz dokładniejsze połączenia między substratem a krzemowymi rdzeniami, a wszystko dzięki twardszemu i sztywniejszemu materiałowi, jakim jest właśnie szkło. Intel na targach NEPCON 2026 w Japonii przedstawił pierwszy realny projekt takiego substratu, choć jedynie w formie slajdu. Technologia Glass Core Substrate oznacza, że konstrukcja pakietu ma układ warstwowy określany jako 10‑2‑10. Pierwsze 10 warstw to warstwy RDL (Redistribution Layers), metaliczne ścieżki i połączenia, które aktywnie przekierowują sygnały i zasilanie między układami i innymi elementami pakietu. Następnie znajdują się dwie warstwy szkła, które zapewniają wysoką sztywność mechaniczną i stabilność wymiarową, przyczyniając się do ograniczenia deformacji i odkształceń. W tym miejscu znajdują się także przelotki TGV (Through Glass Vias), czyli metalizowane kanały przechodzące przez szkło, które umożliwiają połączenia elektryczne między stronami substratu. Po rdzeniu ponownie mamy 10 warstw RDL, które tworzą ścieżki prowadzące sygnały i zasilanie z kierunku wyprowadzeń pakietu.
Procesory Intel Bartlett Lake niemal z całkowitą pewnością nie trafią na konsumencki rynek
Całość ma wymiary 78 mm na 77 mm i została przygotowana pod implementację dwóch chipletów oraz ich wzajemną komunikację za pomocą dwóch mostków EMIB. Intel ujawnił również, że odległość między mikro‑kulkami lutowniczymi (bump pitch) wynosi 45 µm, co wskazuje na bardzo wysoką gęstość połączeń w pakiecie. Na slajdzie zaznaczono także określenie „No SeWaRe”, co sugeruje, że rozwiązanie nie jest projektowane z myślą o rynku konsumenckim, lecz o produktach serwerowych i zastosowaniach AI. Intel nie przedstawił jednak konkretnej daty wprowadzenia pakowania EMIB, natomiast analizy branżowe i doniesienia rynkowe sugerują, że wstępne wprowadzenie rozwiązania rozpocznie się w drugiej połowie 2026 roku, a masowa produkcja i szersze wdrożenia mogą nastąpić między 2026 a 2027 rokiem.
Intel’s glass core substrate unveiled at NEPCON Japan 2026 can only be described as impressive.
— SemiVision️️ (@semivision_tw) January 22, 2026
What stands out most is execution. This isn’t about vision alone; assembly and reliability are already underway. It clearly shows how Intel is positioning glass core substrates as a… pic.twitter.com/9JNaCVe9pM
Powiązane publikacje

Intel Core 7 245HX - nowy procesor Arrow Lake dla wydajnych laptopów. Obsługa Thunderbolt 4, DDR5 i PCI Express 5.0
7
Koniec tanich chipów z drugiego szeregu? UMC szykuje ruch, który odczują nie tylko producenci elektroniki
20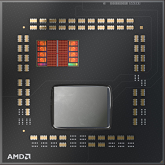
AMD Ryzen 7 5800X3D powróci. Producent szykuje specjalny wariant AM4 10th Anniversary Edition
110
Tesla ujawnia układ AI5 dla FSD, Optimusa i xAI. W produkcji mają pomóc TSMC oraz Samsung Electronics
11







![Intel przedstawia projekt szklanych substratów dla pakowania chipów EMIB na targach NEPCON 2026 w Japonii [1]](/image/news/2026/01/23_intel_przedstawia_projekt_szklanych_substratow_dla_pakowania_chipow_emib_na_targach_nepcon_2026_w_japonii_0.jpg)
![Intel przedstawia projekt szklanych substratów dla pakowania chipów EMIB na targach NEPCON 2026 w Japonii [2]](/image/news/2026/01/23_intel_przedstawia_projekt_szklanych_substratow_dla_pakowania_chipow_emib_na_targach_nepcon_2026_w_japonii_1.png)





